近日,住友电气工业株式会社(以下简称“住友电工”)与大阪公立大学(以下简称“OMU”)在日本科学技术振兴机构(JST)的联合研究项目中取得了一项突破性成果:成功在2英寸多晶金刚石(PCD)基板上成功制备氮化镓高电子迁移率晶体管(以下简称“GaN-HEMT”)。这一技术为移动通信及卫星通信核心器件实现更高容量与更低功耗迈出了关键一步。

2英寸多晶金刚石衬底上实现高频器件用的GaN-HEMT结构
1、散热困境:通信芯片的“高烧”危机
GaN-HEMT是5G基站、雷达和卫星信号传输的核心器件,负责处理大功率高频信号。但随着通信数据量激增,芯片工作时产生的热量也急剧攀升。传统硅(Si)或碳化硅(SiC)衬底导热能力有限,热量堆积不仅降低信号传输效率,还会缩短设备寿命——如同手机长时间玩游戏会发烫降频一样。
2、金刚石登场:散热性能碾压传统材料
金刚石拥有自然界最高的热导率(1200~2000 W/m·K),是硅的12倍、碳化硅的4~6倍。将其作为衬底,可将芯片热阻降低至硅基的1/4、碳化硅基的1/2。此前大阪公立大学的实验已证明:相同功率下,金刚石基GaN芯片温升远低于传统材料。
3、技术突破:纳米级平滑表面的直接键合
过去,多晶金刚石因表面粗糙(5-6纳米)难以与GaN层紧密结合,需依赖焊料或粘合剂,反而阻碍散热。为了实现GaN-HEMT在多晶金刚石上的直接键合,住友电工与大阪公立大学紧密合作突破了两大关键技术:
1、住友电工的抛光技术:将金刚石表面粗糙度降至传统水平一半,达到原子级平整;
2、大阪公立大学的转移技术:将GaN层从硅衬底完整剥离,直接键合至抛光后的金刚石表面。
两者结合,成功地将GaN层直接键合到2英寸的多晶金刚石上。这一成果展示了多晶金刚石基板上的氮化镓结构及其均质散热特性。
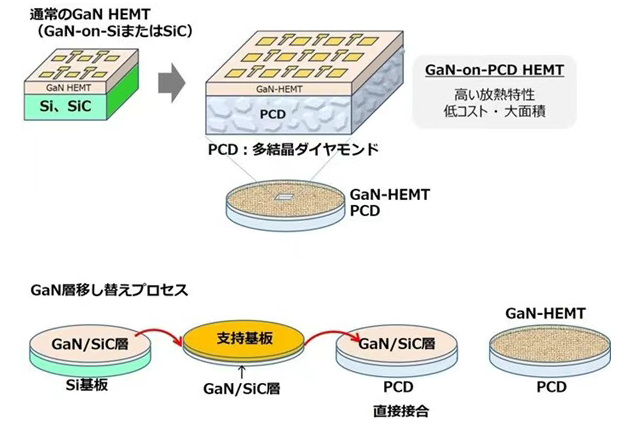
4、散热优势与应用前景
金刚石作为目前自然界中热导率最高的材料之一,具有显著提升散热性能的潜力。金刚石基GaN-HEMT器件在雷达、5G通信、航空航天等领域展现出巨大的应用潜力。当用于相控阵芯片时,可显著提高系统的可靠性并减小系统的尺寸和成本;用于固态功率放大器时,可显著减小器件的尺寸、成本和质量并提升效率;用于宽带通信时,可在减小芯片尺寸成本的同时提升可靠性。
5、键合工艺技术的详解
金刚石基GaN-HEMT的键合工艺技术是实现两者集成的关键方法之一。主要包括表面活化键合、亲水键合、原子扩散键合和水解辅助固化键合等技术。这些技术各有优缺点,例如表面活化键合技术需要高真空度环境,但键合强度高;亲水键合技术步骤简单,但对设备要求低,但可能在大尺寸键合过程中影响键合效果。
6、未来展望
研究团队计划加快开发面向量产的4英寸基板,包括调整设备性能和键合条件。未来,金刚石基GaN-HEMT器件将朝着更大尺寸、更高质量和更低成本的方向发展。通过优化键合工艺,积极开发新型键合材料与方法,有望提升键合质量和性能,进而推动金刚石与GaN集成技术的进步,使其在高性能功率器件制造领域发挥更大作用。


 手机资讯
手机资讯 官方微信
官方微信










 豫公网安备41019702003646号
豫公网安备41019702003646号