高性能计算芯片的多功能集成和小型化推动了自动驾驶、人工智能、6G通信等前沿半导体技术的快速发展,但这一进步也同时加剧了热管理挑战;虽然金刚石增强铜基体(金刚石/铜)复合材料可以通过界面改性获得高的导热系数,但复合材料与半导体材料之间的热膨胀系数(CTE)存在显著的不匹配,沿着长期使用时传热性能的下降,严重阻碍了其工程应用。

图文导读
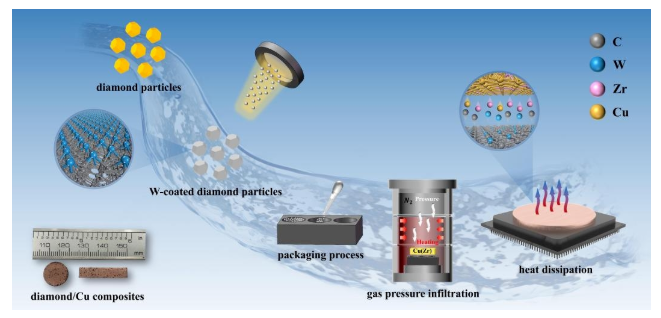
图1.金刚石/铜复合材料的制备过程示意图。

图2.(a)横向周期模型;(B)金刚石(111)/Cu(111)和(c)金刚石(111)/WC(0001)/CuZr(111)的界面结构模型。

图3.(a)WD/Cu(Zr)-t复合材料的TC和ITC值;(B)TC与先前报道的数据的比较,其中橙子、蓝色和红色色块分别代表表面金属化、基体合金化和偶联改性方法。

图4.(a)实时温度响应系统示意图;(B)CuZr合金、WD/Cu(Zr)-0和WD/Cu(Zr)-45复合材料的红外热图像和(c)温度-时间曲线。

图5.(a)WD/Cu(Zr)-0和WD/Cu(Zr)-45复合材料的CTE与Cu、金刚石、SiC和GaN的CTE的比较。(B)金刚石/Cu复合材料在HCST后k的变化。

图6.(a)金刚石颗粒的形态,(B)粒度分布直方图,(c)XRD图谱;(d)镀W金刚石颗粒的形态,(e,f)相应的EDS元素图谱。

图7.来自各种金刚石/Cu复合材料的金刚石颗粒的形态:(a)WD/Cu(Zr)-0和(B)(a)中的局部EDS图;(c)WD/Cu(Zr)-25;(d)WD/Cu(Zr)-35;(e)WD/Cu(Zr)-45和(f)(e)中的局部EDS图。


 手机资讯
手机资讯 官方微信
官方微信










 豫公网安备41019702003646号
豫公网安备41019702003646号